次世代半導体製造工程向け、6μmの極微細レーザー穴あけ加工技術を開発:FAニュース
三菱電機ら4法人は、次世代半導体製造工程向けの極微細レーザー穴あけ加工技術を開発した。パッケージ基板へ6μm以下の穴あけ加工が可能になり、次世代半導体のさらなる微細化への貢献が期待できる。
三菱電機は2022年10月24日、次世代半導体製造工程向けの極微細レーザー穴あけ加工技術を開発したと発表した。東京大学が運用している「TACMIコンソーシアム」において、三菱電機、味の素ファインテクノ、スペクトロニクスが連携した成果だ。
次世代の半導体製造工程では、パッケージ基板に径10μm以下の穴あけ加工が必要になるが、実際の製造に耐える技術開発が課題となっていた。今回の成果では、6μm以下のレーザー穴あけ加工技術を開発し、高い品質と生産性を維持できることを実証した。
パッケージ基板のビルドアップ工法には、味の素ファインテクノが製造するABF(味の素ビルドアップフィルム)が広く使われている。このABFに対し、スペクトロニクスが開発した波長266nm、パルス幅ピコ秒の深紫外短パルスレーザーを、三菱電機が次世代レーザープロセス用開発機に組み込み、東京大学のレーザー加工プロセスのCPS(サイバーフィジカルシステム)化技術を活用して、6μm以下の穴をあけることに成功した。
開発した技術では、6μm以下の微細穴を1秒に数千個あけることができ、高品位加工用のパラメーターにより、6μmの直径でのテーパー度(上面の穴径と下面の穴径の比)が品質基準値の75%を満たすなど、次世代半導体製造パッケージ基板への要求に十分に応えられる。
同技術は、微細化する半導体、複雑化するチップレット技術への適用をはじめ、消費電力の削減やポスト5G、EV(電気自動車)対応などへの貢献が期待される。4法人は、次世代半導体産業における日本の競争力強化を目指し、今後も連携を続け、半導体パッケージ基板のさらなる微細化や高品位化を進めていく。
- 取り付け工数大幅削減の電力計測ユニット、無線通信で配線部材90%削減
- 半導体工場「需要ある限り応える」ダイフク、1600億円投資で描く姿とは
- 操作効率向上と安全性を強化、シュナイダーが次世代ハンディー表示器
- 半導体製造の仮固定工程向けUV照射装置、独自の波長制御でテープを精密剥離
- 高トルクと小型化を両立、山洋電気が5相ステッピングモーターの新モデル
- 3列構成のベアリングで負荷耐性を高めたボールねじサポートユニット
- 絶縁構造の最適化で設置面積削減、富士電機が海外向けモールド変圧器
- マグネットで触れるだけ、振動値を5秒で判定する回転機振動チェッカー
- 設備の長寿命化に向けた取り組み調査、遠隔監視/IoT活用などの実態とは
- 複雑化/大型化するダイカスト部品の高速外観検査、NTNが新たな事業の柱模索
関連記事
 半導体露光機で日系メーカーはなぜASMLに敗れたのか
半導体露光機で日系メーカーはなぜASMLに敗れたのか
法政大学イノベーション・マネジメント研究センターのシンポジウム「海外のジャイアントに学ぶビジネス・エコシステム」では、日本における電子半導体産業の未来を考えるシンポジウム「海外のジャイアントに学ぶビジネス・エコシステム」を開催。半導体露光機業界で日系企業がオランダのASMLに敗れた背景や理由について解説した。 ナノスケールのちりの影響を抑制、半導体製造装置が目指すIoT活用
ナノスケールのちりの影響を抑制、半導体製造装置が目指すIoT活用
「SEMICON Japan 2016」のIoTイノベーションフォーラムで登壇した東京エレクトロン執行役員の西垣寿彦氏は、半導体製造における“ちり”の管理と、IoTを使った生産性向上の取り組みについて紹介した。 72台の装置を半日で稼働、日本発「ミニマルファブ」が変える革新型モノづくり
72台の装置を半日で稼働、日本発「ミニマルファブ」が変える革新型モノづくり
産総研コンソーシアム ファブシステム研究会などは「SEMICON Japan 2016」で、「ミニマルファブの開発成果を発表。同研究会などが推進するミニマル生産方式による製造装置「ミニマルシリーズ」72台を設置し、半導体製造工程のほとんどをカバーできるようになった成果をアピールした。 TSMCはなぜ台湾外初となる3DICのR&D拠点をつくばに設立したのか
TSMCはなぜ台湾外初となる3DICのR&D拠点をつくばに設立したのか
台湾の半導体受託製造大手であるTSMCは2022年6月24日、茨城県つくば市の産業技術総合研究所つくばセンター内に設置した「TSMCジャパン3DIC研究開発センター」の開所式を行った。同センターでは半導体微細化の限界が予想される中、後工程の3次元パッケージ技術の量産を可能とするための技術開発を日本の材料メーカーや装置メーカー、研究機関との共同研究で実施する。 最新レーザー加工技術が東大柏IIキャンパスに集結、高出力ピコ秒DUVレーザーなど
最新レーザー加工技術が東大柏IIキャンパスに集結、高出力ピコ秒DUVレーザーなど
NEDOは、2016〜2020年度にかけて実施中のプロジェクト「高輝度・高効率次世代レーザー技術開発」で開発された最先端のレーザー光源や加工機を集約してレーザー加工の課題解決に寄与するプラットフォーム「柏IIプラットフォーム」を構築したと発表した。 今が復活のラストチャンス、日本政府が進める半導体産業戦略
今が復活のラストチャンス、日本政府が進める半導体産業戦略
日本ケイデンス・デザイン・システムズでは2022年7月15日に、「CadenceLIVE Japan 2022」を横浜ベイホテル東急で開催し、新製品の技術アップデートやユーザー事例の紹介などが行われた。本稿では、経済産業省 デバイス・半導体戦略室長 荻野洋平氏による招待講演の模様を紹介する。
関連リンク
Copyright © ITmedia, Inc. All Rights Reserved.
Factory Automationの記事ランキング
- “見えない基盤”に宿る精度、牧野フライスのモノづくり哲学
- 自動車工場で見えるのに、食品工場では見えないモノ〜今日何個作ると決めたか
- 半導体工場「需要ある限り応える」ダイフク、1600億円投資で描く姿とは
- 安川電機がフィジカルAI市場本格開拓へ、新たな中/長期経営計画策定
- 川崎重工が米国にフィジカルAI社会実装拠点、注力分野は医療/介護など
- 半導体製造の仮固定工程向けUV照射装置、独自の波長制御でテープを精密剥離
- ジェイテクト“過去最高益”へ体質改善、軸受競合の経営統合も「軸をぶらさず」
- センサーレスで旋削主軸をAI診断、異常の早期検知で突発停止を予防
- 軸受業界再編へNSKとNTNが経営統合に基本合意、両トップが語った危機感とは
- 安川電機が協働ロボット新モデル、最大リーチと可搬質量が大幅向上
コーナーリンク
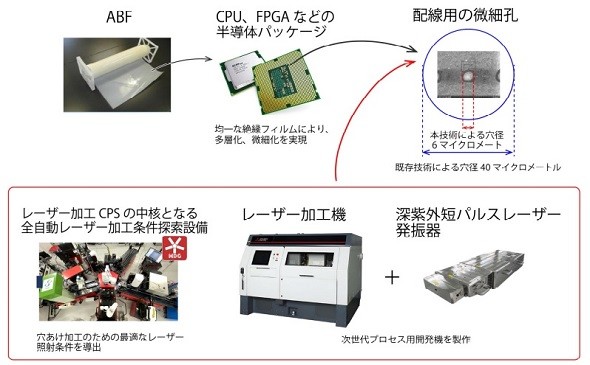
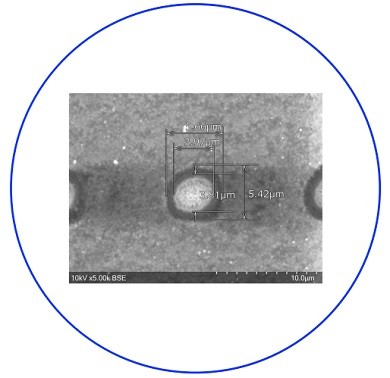 6μm以下の穴あけに成功(青丸は40μm穴に相当するサイズ) 出所:三菱電機
6μm以下の穴あけに成功(青丸は40μm穴に相当するサイズ) 出所:三菱電機


