イオン注入によりr-GeO2半導体にn型導電性を付与することに成功:研究開発の最前線
Patentixは、イオン注入により、r-GeO2に対してn型導電性を付与することに成功した。r-GeO2は、p型、n型の両方の導電制御を可能とする次世代パワー半導体材料だ。
Patentixは2025年7月23日、ルチル型二酸化ゲルマニウム(r-GeO2)に対し、イオン注入によってn型導電性を付与することに成功したと発表した。r-GeO2はバンドギャップが4.68eVと広く、p型、n型の両方の導電制御を可能とする次世代パワー半導体材料だ。
同社はこれまでに、成膜中にアンチモン(Sb)を添加することで電子密度約1020cm−3のr-GeO2のn型制御に成功している。この技術を応用してショットキーバリアダイオードを試作し、ダイオード動作も確認している。一方で、複雑な構造を持つMOSFETなどのパワーデバイスには、表面ごとの不純物濃度を精密に制御する技術が求められていた。
今回の成果では、同社の成膜技術「Phantom SVD法」により作製したアンドープr-GeO2薄膜にSbをイオン注入。膜厚や結晶構造に大きな変化はなく、ルチル構造も維持されていることをX線回折で確認した。シート抵抗の低下やC-V測定の結果から、n型の導電性が付与されたことが確認されている。
また、C-V特性から得られたドナー不純物密度分布は、ドーピングが成膜時ではなくイオン注入によるものであることを示している。今後はI-V測定や質量分析法(SIMS)による分析を通じて、注入された元素がSbであるかを含めた評価を進めていく予定だ。
同社は今後、イオン注入条件の最適化とパワーデバイス試作を通じて、r-GeO2の実用化を推進していく。
関連記事
 SiCへのルチル構造二酸化ゲルマニウム製膜に成功
SiCへのルチル構造二酸化ゲルマニウム製膜に成功
立命館大学とPatentixは、PhantomSVD法を用いて、ルチル構造二酸化ゲルマニウムをSiC上に製膜することに成功した。酸化物半導体パワーデバイス開発の課題となる、基板の低熱伝導率の解決に向けて前進した。 ルチル型二酸化ゲルマニウム薄膜でN型伝導性を確認
ルチル型二酸化ゲルマニウム薄膜でN型伝導性を確認
Patentixは、ドーパント不純物の添加により、世界で初めてルチル型二酸化ゲルマニウム薄膜のN型伝導性を確認した。シリコンと比べ、電気エネルギーの損失が極めて低いパワー半導体の作製が期待される。 半導体パッケージ基板材料の世界市場予測、2025年は前年比8.7%増
半導体パッケージ基板材料の世界市場予測、2025年は前年比8.7%増
矢野経済研究所は、世界の半導体パッケージ基板材料市場について調査した結果をまとめたレポートを発表した。このレポートによれば、コロナ禍明けの半導体需要の低迷を経て市場は回復し、2025年は前年比8.7%増の4327億5000万円に拡大する見込みだ。 強磁性半導体でキュリー温度530K、室温動作のスピン機能半導体デバイスに応用へ
強磁性半導体でキュリー温度530K、室温動作のスピン機能半導体デバイスに応用へ
東京大学は、強磁性半導体(Ga、Fe)Sbにおいてキュリー温度530K(257℃)を達成した。結晶の育成法を見直し、磁性体が常磁性状態から強磁性状態となる際のキュリー温度を大幅に上昇させることに成功した。 半導体製造装置の新工場建設を決定、宇都宮事業所で2025年に稼働予定
半導体製造装置の新工場建設を決定、宇都宮事業所で2025年に稼働予定
キヤノンは、半導体製造装置などを生産する宇都宮事業所に新工場を建設する。半導体製造装置の需要増加が見込まれることから、新工場の建設により生産能力を強化する。
関連リンク
Copyright © ITmedia, Inc. All Rights Reserved.
素材/化学の記事ランキング
コーナーリンク
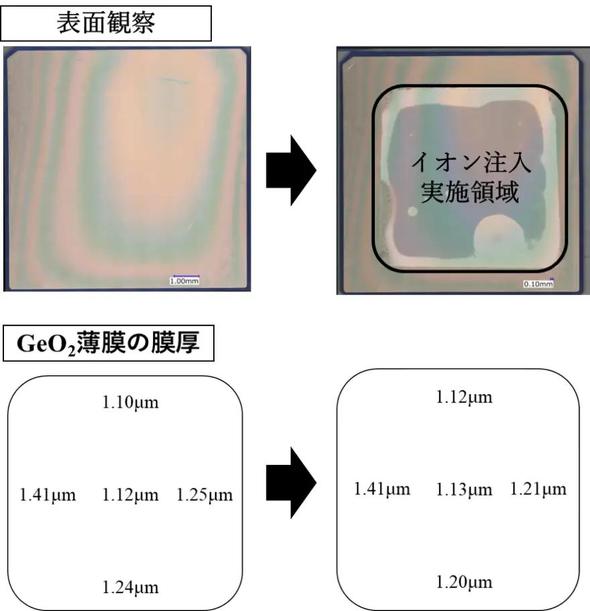
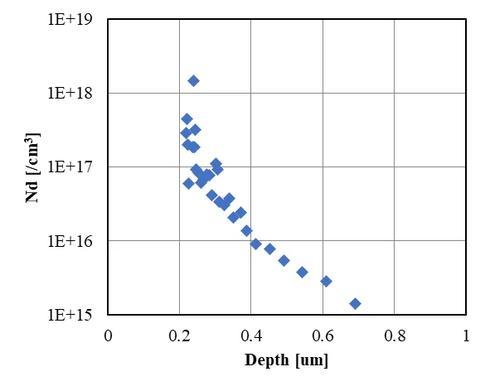 C-V特性から算出されたSbイオン注入領域における r-GeO2薄膜中のドナー不純物密度の深さ方向の依存性 出所:Patentix
C-V特性から算出されたSbイオン注入領域における r-GeO2薄膜中のドナー不純物密度の深さ方向の依存性 出所:Patentix



