第51回 ウェアラブル機器とエンベデッドパッシブ:前田真一の最新実装技術あれこれ塾(2/4 ページ)
2.ビルドアップ基板
ICのピン数が少ない時は、ICのダイパッドからICの部品ピンまでの接続を担うインタポーザには、主にリードフレームが使われます(図4)。
リードフレームは薄い鉄や銅とすずやニッケルなどの合金をプレスして作成するので、非常に安価で作成できます。しかし、ダイパッド(インナーリード)から基板に接続するピン(アウターリード)への接続は1対1にストレートにしか接続できません。
ダイの信号が多くなり、ダイパッドがダイの周辺だけで配置できなくなったり、部品ピンがFPGAやBGAのようにアレイになるとリードフレームでは対応できません(図5)。
ICのピン数が多くなると、チップのダイパッドとBGAのボール配置の位置関係が、複雑に交差してきます。ダイパッドとBGAピン配置が交差すれば、インタポーザには多層の配線板を使わなければなりません。
インタポーザ基板は、外形は小さいのですが、非常にファインな配線が必要になります。このため、マルチ・チップ・モジュール(MCM)をはじめとする複雑なインタポーザには以前からセラミックの多層基板が多く使われていました。ちょうど複雑なインタポーザ基板が必要なICが増加するタイミングでビルドアップ基板の技術が発展しました。
当然なことですが、基板のコストは基板の面積に比例します。このため、インタポーザでは、一般の基板よりも多少コストの高い技術を使っても製品に対するコストへのインパクトはメイン基板ほどには大きくありません。ビルドアップ基板は一般の一括積層基板に比べ、コストは高いのですが、インタポーザ基板はセラミック基板との比較となるので、性能とのバランスでインタポーザ用としては競争力があります。
また、ビルドアップ基板は厚さを薄くできるので、ICを薄く、軽くすることができ、製品の薄型化、はんだ付けの信頼性を上げることができます。プレーン層と配線層の間隔が狭いので、細い配線で、配線のインピーダンスを50Ωにすることができます。
このようにビルドアップ基板はインタポーザ基板の要件を満たしています。このため、現在は、多くの多ピンLSI用インタポーザ基板にはビルドアップ基板技術が使われています。
Copyright © ITmedia, Inc. All Rights Reserved.
Factory Automationの記事ランキング
- 軸受業界再編へNSKとNTNが経営統合に基本合意、両トップが語った危機感とは
- なぜオムロンは農業の“作業”ではなく“判断”の自動化を目指すのか
- 日本が再び世界をリードするための、“シン”モノづくりの世界
- 接触前に停止する協働ロボットに18kg可搬が登場、動作範囲も拡張
- 「自動車以外は全て好調」、四半期受注過去最高のDMG森精機が通期予想上方修正
- 成功率90%超でコンテナ搬送、ヒューマノイドをシーメンス工場に試験導入
- 最大26kWの超高出力化が可能、アマダが新たなファイバーレーザーマシン
- オムロンの制御機器事業が「再成長」に転換、M&Aで欧米顧客基盤を強化へ
- ヒューマノイド導入を支援するコントローラー、既存手法とVLAモデルを統合
- オムロンが電子部品事業を米国投資会社に売却、新会社名はAratasに
コーナーリンク
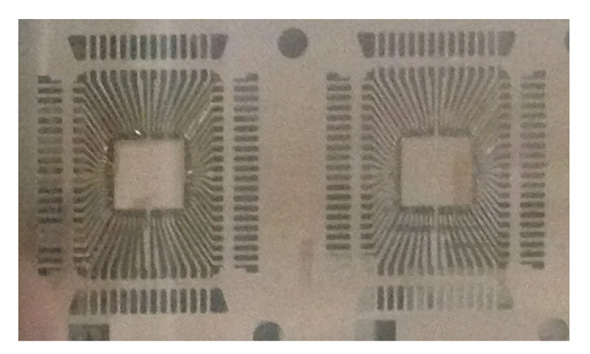 図4:リードフレーム
図4:リードフレーム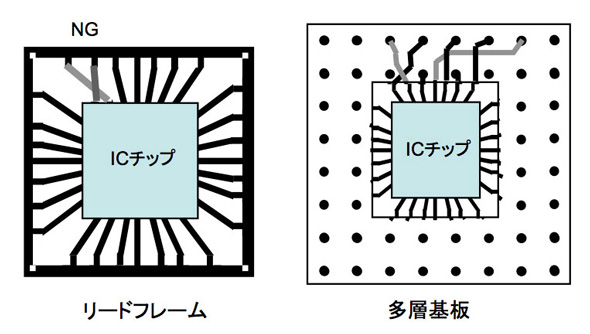 図5:リードフレームでは複雑な配線は不可能
図5:リードフレームでは複雑な配線は不可能


