レーザーで半導体ウエハーのダイシングを行える装置、ディスコが新製品を投入:実装ニュース
ディスコは、半導体ウエハーから各チップを切り出すダイシング工程にレーザーを用いるステルスダイシング(SD)レーザーソーの新製品「DF7361」を開発。「SEMICON Japan 2013」で展示する。
ディスコは2013年11月25日、半導体ウエハーから各チップを切り出すダイシング工程にレーザーを用いるステルスダイシング(SD)レーザーソーの新製品「DF7361」を開発したと発表した。「SEMICON Japan 2013」(2013年12月4〜6日、幕張メッセ)で展示する。販売開始時期は2014年4月となっている。
ステルスダイシングとは、レーザーを半導体ウエハーなどの加工対象の内部に集光することで任意の位置に改質層を形成し、半導体ウエハーを保持するテープを引っ張って広げるテープエキスパンドなどによってチップに個片化するダイシング技術である。ディスコが培ってきたダイヤモンド砥石を用いて行う従来のブレードダイシング技術と、浜松ホトニクスがディスコ向けに開発したステルスダイシング技術を融合したのが、SDレーザーソーだ。
DF7361は、さまざまな製造プロセスが検討されているTSV(シリコン貫通電極)を用いたデバイスのダイシングを行えるように、装置側で柔軟な対応が可能な仕組みを取り入れている。装置側での柔軟な対応は、顧客のさまざまな要求に応える必要のある組み立て工程の受託業者も求めていたものだ。
従来のSDレーザーソーは、フレーム搬送とウエハー搬送、それぞれに対応する装置を用意していた。DF7361は、使用カセットを変更することにより、1台の装置でフレーム搬送とウエハー搬送の両方に対応できる。また、SDレーザーソーを単独で使用するスタンドアロン仕様から、薄ウエハー加工を行う研削・研磨装置と接続するインライン仕様まで、将来のプロセス変更にも対応できる装置設計になっているという。
関連記事
 第3回 TSVがもたらす新しいMCM
第3回 TSVがもたらす新しいMCM
実装分野の最新技術を分かりやすく紹介する前田真一氏の連載「最新実装技術あれこれ塾」。第3回は、パッケージ内でメモリチップを積層するためのキーテクノロジとして注目されている「TSV」について紹介する。 第25回 量産技術化が進むTSV
第25回 量産技術化が進むTSV
実装分野の最新技術を分かりやすく紹介する前田真一氏の連載「最新実装技術あれこれ塾」。第25回は、量産技術として開発が加速しているTSV(Through Silicon Via)の最新動向を解説する。 第26回 TSV実用化に向けて
第26回 TSV実用化に向けて
実装分野の最新技術を分かりやすく紹介する前田真一氏の連載「最新実装技術あれこれ塾」。第26回は、第25回に引き続きTSV(Through Silicon Via)について取り上げる。話題先行で実用化までまだ時間がかかると思われているTSVだが、ソニーの裏面照射CMOSセンサーの新製品にはTSVが適用されているのだ。
Copyright © ITmedia, Inc. All Rights Reserved.
Factory Automationの記事ランキング
- 軸受業界再編へNSKとNTNが経営統合に基本合意、両トップが語った危機感とは
- オムロンの制御機器事業が「再成長」に転換、M&Aで欧米顧客基盤を強化へ
- ファナックがGoogleと協業、AIエージェントでロボットを操作へ
- ファナックがNVIDIAと連携強化、物理エンジンで高精度デジタルツイン
- なぜオムロンは農業の“作業”ではなく“判断”の自動化を目指すのか
- 成功率90%超でコンテナ搬送、ヒューマノイドをシーメンス工場に試験導入
- 最大5台まで月2万円から、パナソニックコネクトのロボット制御基盤が拡充
- 日本が再び世界をリードするための、“シン”モノづくりの世界
- データセンターが過去最高に貢献も、アマダは体制変更で新中計へ
- 高速ラインでの高精度な検査を可能にする、組み込みAIビジョンシステム
コーナーリンク
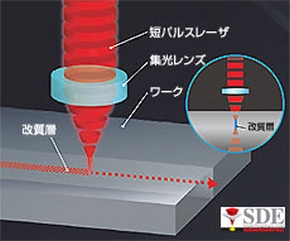 ステルスダイシングの概略図
ステルスダイシングの概略図 SDレーザーソー「DF7361」
SDレーザーソー「DF7361」


