第25回 量産技術化が進むTSV:前田真一の最新実装技術あれこれ塾(2/4 ページ)
2. TSVの必要性
これまでもMCM-Dやメモリチップを積層して容量を増やした製品は存在しました。
チップの積層はワイヤーボンディングを使って実現できます(図3)。
シリコンインタポーザの積層配線はIC内部の配線と同様に作成できます。現在、IC内部の配線層(メタル層)は10層以上となっています(図4)。
インタポーザにはこれほどの多層は必要ありません。シリコンインタポーザからパッケージのインタポーザへワイヤーボンディングで接続すれば簡単です(図5)。
TSVを使用するメリットは現在、SiP(System in Package)の集積度向上に注目されています。
例えば、ワイヤボンディングを使ったチップの3次元実装ではチップをずらせて積層する必要があります。また、チップにボンディングをする際にチップに力がかかるので、チップを薄くすることができず、積層すると厚くなります。さらに、ボンディングパッドの数が多くなり、パッドのエリアもインタポーザ上に広く必要となります(図6)。
しかし、TSVのメリットはこれだけではありません。電気特性の向上に大きな意味があります。
ボンディングパッドのピッチを狭くするためにはボンディングワイヤの径は細くする必要があります。また、パッドの数の増加に従い、チップとパッドとインタポーザのパッド距離が長いものが多くなります(図7)。
細くて長いワイヤは大きなL成分をもちます。
L成分は信号の伝搬を遅らせ、波形歪みの原因となります。
例えば、現在注目されている問題にPI(Power Integrity)があります。これは、ICの消費電力の変化によって、ICの電源電圧が変動し、信号のタイミングを変化させたり、電磁放射の原因となったりします(図8)。
この電源供給ラインに存在するL成分がICの電圧変動の原因となっています。
TSVを使用することにより、電源電圧変動(バウンス)を大幅に減少させることができます。
高速信号の伝送も同じです。例えば複数のメモリチップをコントローラの上に積層した場合、TSVを使用すれば、コントローラと各メモリチップは最短で結ばれ、少ない電流で歪みのないデータ伝送が実現できます(図9)。
しかし、同じ積層でもワイヤボンディング接続では、細くて長い配線を介し、各チップが結ばれます。しかもワイヤは伝送線路としてみても、インピーダンスの制御が困難です(図10)。長く不安定な伝送線路で信号を伝えるためには、電流を多く流し、終端で波形を整える必要があります。
大電力を使って、品質の悪い信号を伝達します。
例えば、韓国Hynix Semiconductor社はDDR3メモリチップを8層積層した場合、TSVではワイヤボンディングに比べ動作速度の50%向上、消費電を40%削減が達成できたと2011年3月に発表しました(図11)。
Copyright © ITmedia, Inc. All Rights Reserved.
Factory Automationの記事ランキング
- 自動車工場で見えるのに、食品工場では見えないモノ〜今日何個作ると決めたか
- “見えない基盤”に宿る精度、牧野フライスのモノづくり哲学
- 安川電機がフィジカルAI市場本格開拓へ、新たな中/長期経営計画策定
- ジェイテクト“過去最高益”へ体質改善、軸受競合の経営統合も「軸をぶらさず」
- 半導体工場「需要ある限り応える」ダイフク、1600億円投資で描く姿とは
- 川崎重工が米国にフィジカルAI社会実装拠点、注力分野は医療/介護など
- 安川電機が協働ロボット新モデル、最大リーチと可搬質量が大幅向上
- 軸受業界再編へNSKとNTNが経営統合に基本合意、両トップが語った危機感とは
- 半導体製造の仮固定工程向けUV照射装置、独自の波長制御でテープを精密剥離
- センサーレスで旋削主軸をAI診断、異常の早期検知で突発停止を予防
コーナーリンク
 図3 ボンディングを使ったチップの積層(エルピーダメモリ
図3 ボンディングを使ったチップの積層(エルピーダメモリ 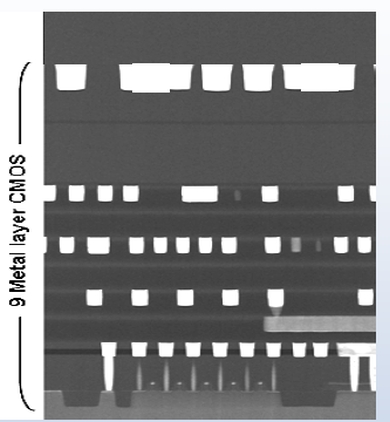 図4 ICの多層配線(9層)(Tier Logic Hot Chips 2010)
図4 ICの多層配線(9層)(Tier Logic Hot Chips 2010)
 図6 大きなボンディングパッド領域が必要(SPT社資料より)
図6 大きなボンディングパッド領域が必要(SPT社資料より) 図7 細くて長い配線は大きなLをもつ
図7 細くて長い配線は大きなLをもつ 図8 電源電圧変動はノイズ源
図8 電源電圧変動はノイズ源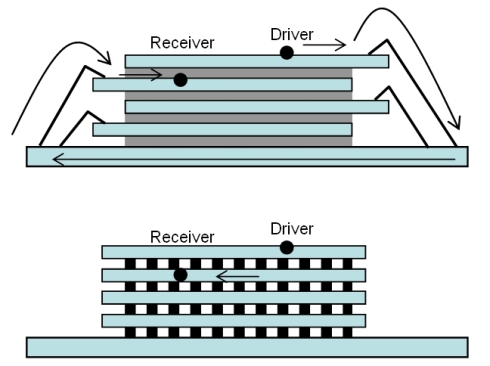
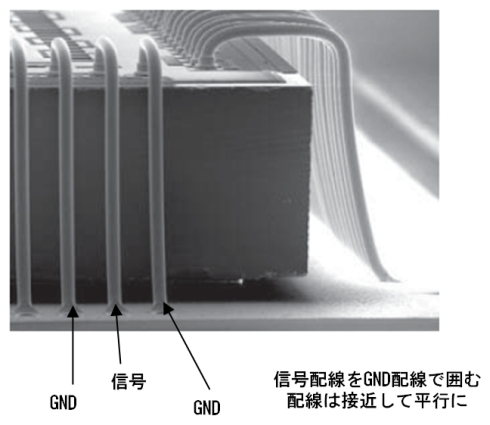
 図11 Hynixの8層積層メモリ(Server Memory Forum 2012)
図11 Hynixの8層積層メモリ(Server Memory Forum 2012)


