1μm以下の極薄半導体チップを高スループットで実装、東レエンジが技術開発:FAニュース
東レエンジニアリングは、NEDO(新エネルギー・産業技術総合開発機構)の助成事業において、極薄半導体チップを高スループットで実装する技術を開発した。
東レエンジニアリングは2025年8月28日、オンラインで記者会見を開き、NEDO(新エネルギー・産業技術総合開発機構)の助成事業において開発した極薄チップの実装技術について説明した。
先端半導体では、さらなる高性能化、低電力化を実現するために、半導体チップの極薄化への要求が高まっており、極薄のHBM(広帯域メモリ)やデータなどをやりとりするブリッジチップ、さらに次世代集席回路などのハンドリングが求められている。
従来、これら半導体チップをダイシングテープから分離させる方法として、針状のピンで突き上げて取り出すニードルピックやテレスコピック、スライダーといった方式が用いられていたが、厚み20μm以下になるとハンドリング時の歩留まりが大幅に低下することが課題となっていた。
今回、東レエンジニアリングは、NEDOの助成事業「ポスト5G情報通信システム基盤強化研究開発事業」で、高精度レーザー加工位置制御技術と、レーザー転写プロセスに最適化したレーザー光学系を開発した。LEDをディスプレ基板に実装する際などに使用されるレーザー転写技術を応用したもので、東レエンジニアリングでは「スキャン方式」と呼んでいる。
レーザー転写では、ダイシングテープやガラス基板などのキャリア基板にレーザーを照射して接着剤に反応を起こし、チップを剥離させてキャッチ基板に転写する。従来はマイクロLEDやミニLEDのレーザー転写において主に1ショットごとに1個ずつチップを転写する「1by1方式」が用いていたが、新しいスキャン方式では微小なレーザーをチップの端部から順に照射する。これにより、極薄チップを高い歩留まりでキャリア基板から剥離(はくり)し、キャッチ基板に転写できるようになった。
「今までの方式では大きなレーザーを一括で当てると、テープ部分の変形が大きくなり、チップに与えるダメージも大きくなってしまう。チップより小さなレーザーを使ってチップを少しずつ剥離させることで、厚みが1μm以下の極薄チップでもダメージを低く抑えて転写させることが可能になった」(東レエンジニアリング 開発部門開発部 主任技師の岡田達弥氏)
これによって、先端半導体に使用される厚み20μm以下の半導体チップや、次世代光集積回路に使用される厚み1μm以下の化合物チップを、量産時に求められる精度を保ちながら、従来比10倍以上の効率で生産することが可能となった。
開発したレーザー転写技術を実証するため、チップサイズ5mm×5mm、厚み10μmの半導体チップを試作し、実証試験によって精度±2μm(3σ)で転写することに成功。転写したチップの外観検査や抗折強度測定によって、チップに有意なダメージがないことも確認できたという。
チップサイズ0.15mm×0.70mm、厚み1μm以下のInP(インジウムリン化合物)やTFLN(薄膜ニオブ酸リチウムチップ)など化合物チップの転写とシリコン基板への接合に成功し、化合物チップの実装プロセスへの適応性を実証した。
東レエンジニアリングでは、先端半導体パッケージの量産が始まる2030年頃の適用を目標に、ユーザーと製品開発に取り組んでいく。
関連記事
 インタポーザはどう変わる? オーク製作所のダイレクト露光装置に数十社関心
インタポーザはどう変わる? オーク製作所のダイレクト露光装置に数十社関心
オーク製作所がNEDOの委託事業を受けて、新たなダイレクト露光装置を開発した。今後のインタポーザのトレンドに対応した、装置となっており既に多数の企業から引き合いが来ているという。 ニコン初の半導体デバイス製造後工程向け露光装置、600mm角の大型基板対応
ニコン初の半導体デバイス製造後工程向け露光装置、600mm角の大型基板対応
ニコンは、半導体デバイス製造の後工程にあたるアドバンストパッケージング向けに、1.0μm(L/S)の高解像度かつ600mm角の大型基板に対応した、デジタル露光装置「DSP-100」の受注を開始する。 半導体デバイス微細化で新たな電子ビーム方式に需要、量産などで資本業務提携
半導体デバイス微細化で新たな電子ビーム方式に需要、量産などで資本業務提携
芝浦メカトロニクスとPhoto electron Soulは、半導体フォトカソード型電子ビーム生成システムの量産およびメンテナンスに関する資本業務提携で合意した。半導体デバイスの微細化、積層化に伴い高精度な電子ビーム方式の検査需要が高まっており、供給体制を強化する。 超小型産業用カメラを日本で本格展開、クリーンルームでのウエハー検査も対応
超小型産業用カメラを日本で本格展開、クリーンルームでのウエハー検査も対応
ドイツの産業用カメラメーカーXIMEAは、超小型かつ高性能カメラ「xiMU」シリーズの日本市場向け展開を強化する。重量5gで15mm角ながら、500万画素および2000万画素のCMOSセンサーで最大50fpsに対応する。 最先端プロセス対応の半導体計測装置、最大6倍の高速化を実現
最先端プロセス対応の半導体計測装置、最大6倍の高速化を実現
リガクは、半導体製造におけるウエハー表面の微量汚染分析に対応した、全反射蛍光X線(TXRF)分析装置「XHEMIS TX-3000」の販売を開始した。 半導体アドバンスドパッケージ向けステッパ露光装置、ウシオ電機が2026年度発売へ
半導体アドバンスドパッケージ向けステッパ露光装置、ウシオ電機が2026年度発売へ
ウシオ電機は、半導体アドバンスドパッケージ向けの新型ステッパ露光装置「UX-59113」の開発を完了し、2026年度中に発売する。解像度1.5μmで100mm角以上の露光フィールドを1ショットでできる。
関連リンク
Copyright © ITmedia, Inc. All Rights Reserved.
Factory Automationの記事ランキング
- “見えない基盤”に宿る精度、牧野フライスのモノづくり哲学
- 半導体工場「需要ある限り応える」ダイフク、1600億円投資で描く姿とは
- 安川電機がフィジカルAI市場本格開拓へ、新たな中/長期経営計画策定
- 半導体製造の仮固定工程向けUV照射装置、独自の波長制御でテープを精密剥離
- ジェイテクト“過去最高益”へ体質改善、軸受競合の経営統合も「軸をぶらさず」
- 自動車工場で見えるのに、食品工場では見えないモノ〜今日何個作ると決めたか
- 川崎重工が米国にフィジカルAI社会実装拠点、注力分野は医療/介護など
- センサーレスで旋削主軸をAI診断、異常の早期検知で突発停止を予防
- 軸受業界再編へNSKとNTNが経営統合に基本合意、両トップが語った危機感とは
- オムロンが電子部品事業を米国投資会社に売却、新会社名はAratasに
コーナーリンク


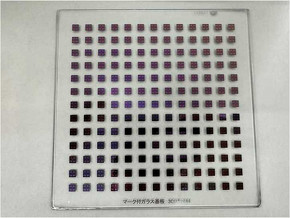 半導体チップの転写サンプル 出所:東レエンジニアリング 光半導体チップの接合サンプル
半導体チップの転写サンプル 出所:東レエンジニアリング 光半導体チップの接合サンプル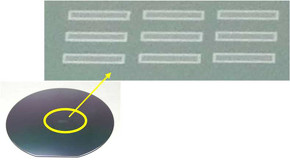 光半導体チップの接合サンプル 出所:東レエンジニアリング
光半導体チップの接合サンプル 出所:東レエンジニアリング


